논문 읽기 01: 'Atomic layer deposition: An overview', Chem. Rev. (2010), 110, 111-131
Atomic Layer Deposition: An Overview
해당 논문은 2010년에 콜로라도 대학 Steven M. George가 쓴 논문으로, 원자층증착법(Atomic Layer Deposition, ALD)에 대한 개괄적인 내용을 담고있다. 학부생 연구원 시작하면서 가장 먼저 읽은 논문이다. 나온지 10년 가까이 됐지만 다양한 사례를 들어 ALD의 개념을 설명하는 논문이라 지금 읽어도 좋은 것 같다.
예전에 읽고 제대로 백업/관리를 안해서 다시 찾다보니 옛 기억이 새록새록 떠오른다. 논문 내용과 내가 아는 내용을 정리해서 노트로 만들어 정리해두고자 한다.
Atomic Layer Deposition?
History of ALD
ALE/ALD의 역사는 1970년대 핀란드의 Tuomo Suntola의 ZnS의 ALE 시스템 개발1에서 시작됐다. 그 이후로 후속 연구들이 진행되어 학술 논문과 특허들이 나왔고, ALE가 처음으로 적용된 전자발광식 디스플레이가 1983년부터 1998년까지 헬싱키 공항에 전시되었다. 첫 상용 ALE 반응기인 F-120가 1988년에 판매되었다. 제조사인 Microchemistry는 나중에 ASM이 된다.2,3 2000년대 이전에는 ALE(Atomic Layer Eptaxy)로 불리기도 했는데, 기판 위에서 대부분의 박막 성장이 에피택셜하게 성장하지 않는다는 결과 이후로 ALD란 용어가 더 널리 쓰이게 됐다.
What is ALD?
ALD는 화학기상증착법(CVD)의 일종으로, 전구체(precursor)를 순차적 단계에 따라 반응기에 공급하여 박막을 성장시키는 기술이다. Binary sequence ALD가 가장 기본적인 형태로, Al2O3를 예로 들면, 금속 원소 Al을 포함하는 유기 금속 전구체와 반응 자리를 새로 만들어주는 oxygen source가 번갈아 공급되며 박막을 성장시킨다. 각 단계별로 공급된 전구체는 기판 표면의 반응자리와 전부 반응할 때까지 화학 흡착을 일으키고, 과량 공급되어도 reactive site가 포화 상태라면 더이상 반응이 일어나지 않는다. 이것을 ALD의 가장 큰 특징중 하나인 자기 제한적 거동(Self-limiting growth behavior)라고 부른다. 일반적인 CVD는 반응이 동시에, 연속적으로 일어나는 반면에 ALD는 전구체 공급 단계와 배출 단계가 들어가있는 것이 가장 큰 차이다. ALD의 자기 제한적 거동과 전구체의 순차적 공급 때문에 박막의 두께를 옹스트롬(Å) 단위로 조절할 수 있다. 옹스트롬 단위는 1/10nm로, 원자 수준으로 두께를 조절할 수 있어서 원자층증착법이라고 부른다. 이런 특징 때문에 높은 종횡비(high aspect ratio)를 갖는 구조에서도 균일한 두께로 박막을 성장시킬 수 있고, 초미세공정으로 돌입한 반도체 산업에서 중요한 공정으로 자리잡고 있는 것이다.
전구체는 기체 상태로 반응기에 공급되고, 기판의 기하학적 형상과 무관하게 모든 공간을 채운다. 전구체 공급 라인을 기판을 향해 직결할 필요도 없다. 오직 반응기 크기에 의한 제약만이 존재한다. 기판 표면에서의 반응도 순차적으로 진행되기 때문에 전구체끼리 반응을 일으키지 않는다.
다음 그림은 ALD의 순차적인 반응 단계를 도식화 한 것이다.
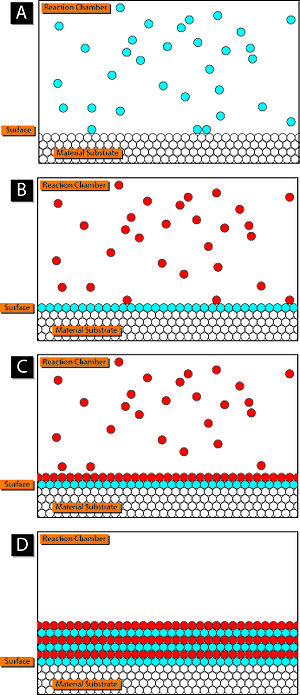
Thermal or Plasma-Enhanced ALD
ALD는 기본적으로 CVD와 연관이 깊어서 Thermal ALD의 경우 CVD의 binary reaction에 기반을 두고 있다. CVD와 같은 베이스를 갖는 반응물들은 다음과 같다.
| Type | Compound |
|---|---|
| Binary Metal Oxide | Al2O3, TiO2, ZnO, ZrO2, HfO2, Ta2O5 |
| Binary Metal Nitride | TiN, TaN, W2N |
| Others | ZnS, CdS, GaP, InP |
Plasma/Radical을 이용할 경우 Thermal ALD로는 어려운 단일 성분의 ALD 박막을 증착3할 수 있다. H2 플라즈마를 이용한 Ti4, Ta5 ALD가 있다. PE-ALD(Plasma Enhanced-ALD)는 Themal ALD보다 훨씬 낮은 온도에서 박막을 증착할 수 있고, 이러한 특성은 열에 약한 기판이나 폴리머에도 ALD 박막을 증착6할 수 있는 가능성을 제공한다.
ALD reactor
다음 그림은 실험실 수준의 viscous flow reactor 구조를 개략적으로 나타낸 것이다.7 기본적인 구성은 아래 그림과 같고, 필요에 따라 반응기 디자인이 달라지거나 RF generator, QCM, in situ FT-IR과 같은 부수적인 장비들이 추가된다.
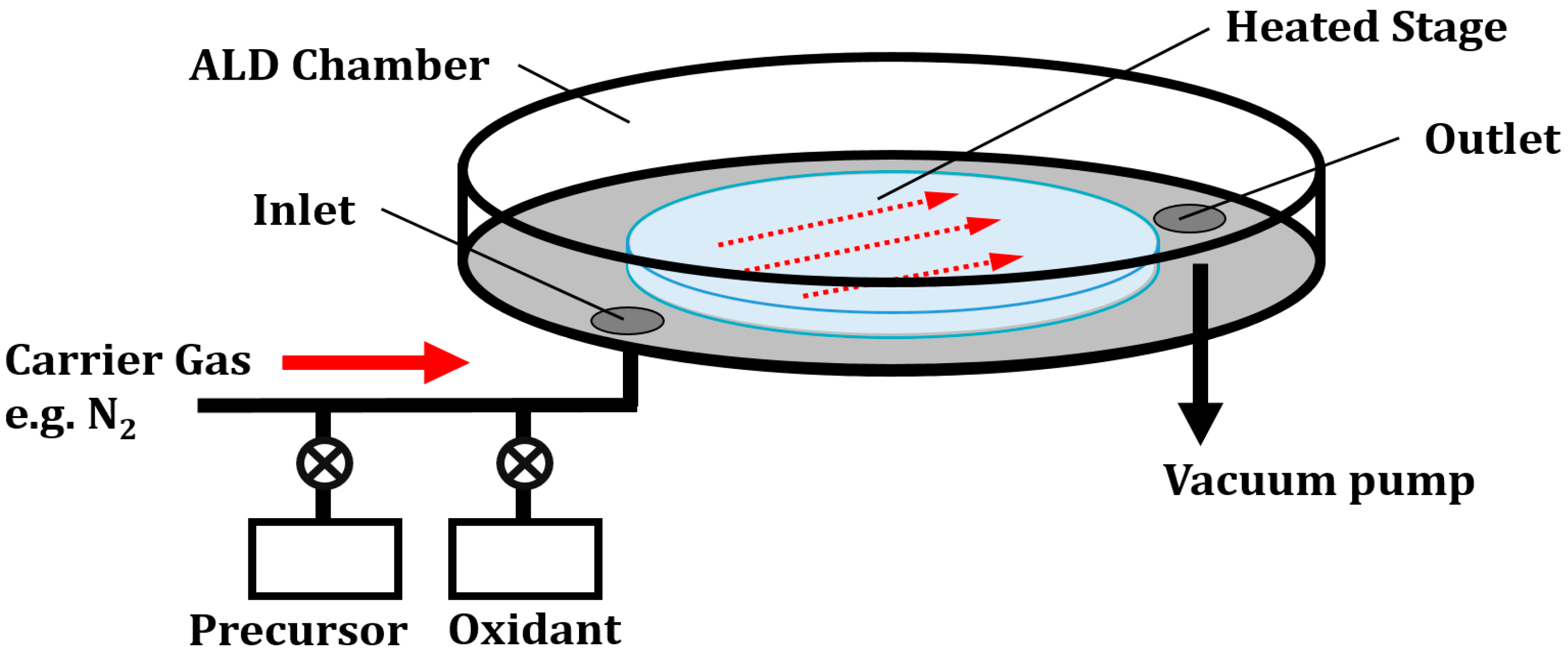
전구체의 증기압에 따라서 carrier gas 유무를 선택할 수 있다. 증기압이 낮은 전구체의 경우, 펌프가 끌어올리는데 긴 시간을 필요로 할 것이다. 그런 경우 carrier gas를 사용하면 효과적으로 증착 단계를 진행할 수 있다. Viscous flow reactor에서 전구체의 비말 동반과 기체의 상호 확산 사이에서 carrier gas의 최적 증기압은 약 ~1 Torr다 (N2 기준). 만약 증기압이 ~1 Torr 이하일 경우 기체의 평균 자유 경로(mean free path)가 멀어져서 carrier gas의 비말 동반 효과가 덜할 것이다.
다음 그림은 다양한 종류의 ALD reactor를 개략적으로 나타낸 그림이다.8 전구체의 공급 방식에 따라 flow-type과 showerhead로 나뉘고, 반응기의 기판 용량에 따라 single wafer와 batch로 구분할 수 있다. 반응에 필요한 에너지원에 따라 thermal 또는 energy enhanced로 구분할 수 있고, 반응이 공간의 제약이 있느냐 전구체 공급 시간에 제약이 있느냐로 temporal과 spatial로 구분할 수 있다.
| Reactor type | |
|---|---|
| Precursor dosing | variation |
Flow-type | single wafer / batch |
Showerhead | thermal / energy enhanced |
temporal / spatial |

Enjoy Reading This Article?
Here are some more articles you might like to read next: